ニコンインダストリアルソリューションズ事業部が開発した画像測定システムとLSI検査顕微鏡用ウェハローダを組み合わせた、「ウェハ自動計測ソリューション」の導入により、集積回路(IC)製造におけるウェハレベルの品質管理を目的とした自動光学検査(AOI)装置設置の資本投資が半減しました。お客様の要件に合わせて独自のスキャンシーケンスを作成可能なため、通常の自動光学検査システムよりも変更時のダウンタイムを抑えられます。その結果さまざまな要件に応じたツールを使用できるので、ウェハレベルのプロセス管理を強化することが可能です。現在市場に出回っている高価な専用自動光学検査装置は、厳密な自動手順に従って露光済みウェハ表面全体に対してスキャンを行い、発生する可能性がある不良についてデータを収集します。それに対して、ニコンの低コストで柔軟なソリューションはプログラム可能な画像測定システムを基盤としており、品質管理要件に応じて高度にプログラムすることができ、最適な検査サイクルを実施することができます。この新しい品質最適化の手順をよく示す例として、試験導入を先日完了したシンガポールの企業の事例をご紹介します。同社は、厳密な寸法管理を必要としないため、金型上で直径8インチ(200 mm)のウェハ全体では、精密な寸法計測を実施する必要はありませんでした。一方で、外周部、および中心付近の一定間隔で配置された複数の領域については精密な寸法測定が必要でした。また、直径6インチ(150 mm)のウェハでも同様の検査が必要でした。

このシステムでは高スループットが求められましたが、ニコンNWL200自動ウェハローダによって実現しました。このローダはウェハを1つずつカセットから画像測定機に移動させて検査後に戻すもので、人による操作はまったく不要です。不良が見つかったウェハは再加工され、正常なウェハは下流工程に送られてバックエンド工程へと移ります。システムの監視と追跡に使用するグラフィックユーザーインターフェイスでは、業界標準のSECS/GEMプロトコルを使用して設備からホストにデータが送られます。また、この自動化システムはコンパクトで、故障発生までの平均時間が長くメンテナンスコストが低いことが特長となっています。ウェハがNEXIV VMZ-S3020に設置されると、8インチウェハ中心部の9つの領域の画像取得と測定は約10秒で完了し、ウェハ周辺部の検査は4分のサイクルで完了し、180枚の分析用画像が生成されます。
このような測定を実施するため、ニコン 画像測定システム NEXIV VMZ-S3020による特定の領域の指定とプログラミングが必要となりますが、それには標準ソフトウェアのAutoMeasureを使用すると簡単に進めることができます。画像測定システムのもう1つの特長がさまざまな照明オプションを利用できるという点です。明視野と暗視野の両方に対応しており、検査実行中に照明の調光をプログラムできます。明視野はフォトレジスト汚染の検出に、暗視野は半導体表面の傷の有無の確認に適しています。どちらを使用しても、短絡の原因となったり、将来的にICの機能に何らかの悪影響を及ぼす原因となり得る微粒子の存在を検出することができます。たとえば、暗視野照明を使用すると、背景やウェハパターンと比較して明度のグレーレベルが高い粒子を検出することができます。明視野照明では、コントラストの差を測定して不良を検出します。ウェハ周辺部の検査では、明度によりシールリング内部の不良を検出します。

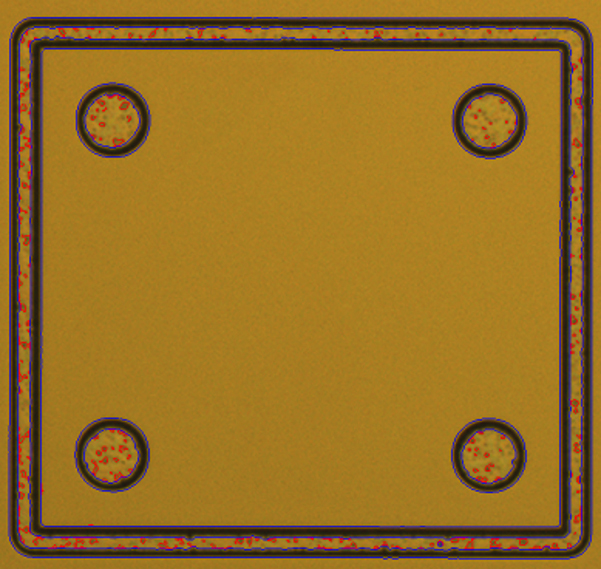

NEXIV VMZ-Sのもう1つの大きな特長が自社開発リニアエンコーダです。すべての軸で0.01 μmという高分解能であるため、最小トラック幅0.8 μmという高精度の限界寸法(CD)計測が可能です。さらに詳しい情報はこちらでご覧いただけます。